日本ShinEtsu信越半导体封装材料应用用途
信越半导体封装材料使用了独特的高可靠性新阻燃剂,从而发挥出了耐热性、难燃性、耐湿性、电力特性等优越的性能。适用于BGA、SMD、SIP等各类的尖端半导体封装,强化了封装材料的产品阵容,也满足了各方面的需求。
日本ShinEtsu信越离散性电子元件封装材料
信越离散性电子元件封装材料拥有高热传导性和卓越的成型性。有减少模具损耗型和具有低应力性型等各种类型,可满足客户的不同需求。
信越离散性电子元件封装材料产品型号及工业应用参数
| 离散性电子元件封装材料型号 | 特征 | 螺旋流动 | 比重 | 玻璃转换温度 | 线膨胀係 α1 | 弯曲强度 | 弯曲弹性率 | 热传导率 |
| 单位 | cm | - | ºC | ppm/ºC | N/mm² | N/mm² | W/mK | |
| KMC-103 | 标准 | 80 | 1.81 | 170 | 20 | 140 | 13,000 | 0.6 |
| KMC-130 | 高耐湿 | 50 | 1.80 | 160 | 19 | 140 | 14,000 | 0.6 |
| KMC-120MK | 高热传导 (实型铸造、功率电晶体用) | 50 | 2.25 | 165 | 20 | 150 | 23,000 | 2.5 |
| KMC-125 | 65 | 2.20 | 165 | 20 | 155 | 21,000 | 2.3 | |
| KMC-520 | 60 | 2.25 | 150 | 21 | 150 | 22,000 | 2.1 |
日本ShinEtsu信越薄型封装用封装材料
信越化学的薄型封装用封装材料是运用本公司迄今为止培育起来的低应力性技术,而提供的具有优越的耐湿性和耐回流性的,能适用于各类封装的树脂。
信越薄型封装用封装材料产品型号及工业应用参数
| 薄型封装用封装材料型号 | 用途 | 螺旋流动 | 比重 | 玻璃转换温度 | 线膨胀係 α1 | 线膨胀係 α2 | 弯曲强度 | 弯曲弹性率 |
| 单位 | cm | - | ºC | ppm/ºC | ppm/ºC | N/mm² | N/mm² | |
| KMC-180 | LQFP, TQFP, QFP, TSOP, TSSOP, SOP | 80 | 1.89 | 160 | 13 | 57 | 120 | 13,000 |
| KMC-184 | 90 | 1.89 | 160 | 13 | 57 | 120 | 13,000 | |
| KMC-188 | 90 | 1.89 | 165 | 13 | 57 | 120 | 13,000 | |
| KMC-289 | 90 | 1.94 | 140 | 11 | 45 | 140 | 19,000 |
日本ShinEtsu信越环保型环氧树脂封装材料
信越化学的环保型绿色环氧树脂是使用独特的高可靠性的新阻燃剂,从而发挥出了耐热性、难燃性、耐湿性、电力特性等优越的性能。适用于BGA、SMD、SIP等各类的尖端半导体封装,强化了封装材料的产品阵容,也满足了各方面的需求。
信越环保型环氧树脂封装材料产品型号及工业应用参数
| 环氧树脂封装材料型号 | 用途 | 螺旋流动 | 比重 | 玻璃转换温度 | 线膨胀係 α1 | 线膨胀係数 α2 | 弯曲强度 | 弯曲弹性率 |
| 单位 | cm | - | ºC | ppm/ºC | ppm/ºC | N/mm² | N/mm² | |
| KMC-3800 | LQFP, TQFP, QFP, TSOP, TSSOP | 90 | 2.00 | 130 | 9 | 32 | 150 | 22,000 |
| KMC-300 | 160 | 1.99 | 130 | 11 | 45 | 150 | 22,000 | |
| KMC-3510 | 85 | 1.98 | 140 | 9 | 40 | 150 | 21,000 | |
| KMC-284 | CSP, BGA, MCP | 110 | 2.01 | 130 | 9 | 35 | 150 | 25,000 |
| KMC-3580 | 150 | 1.98 | 130 | 11 | 45 | 150 | 21,000 | |
| KMC-6000 | 100 | 2.00 | 145 | 8 | 34 | 140 | 22,000 |
日本ShinEtsu信越BGA用树脂封装材料
信越化学的BGA用树脂是适合于单面成型的技术,成型后的封装实现了低弯曲。是适合于大型基板、窄间距、长线的封装。
信越BGA用树脂封装材料产品型号及工业应用参数
| BGA用树脂封装材料型号 | 用途 | 螺旋流动 | 比重 | 玻璃转换温度 | 线膨胀係数 α1 | 线膨胀係数 α2 | 弯曲强度 | 弯曲弹性率 |
| 单位 | cm | - | ºC | ppm/ºC | ppm/ºC | N/mm² | N/mm² | |
| KMC-211 | CSP, BGA, MCP | 115 | 1.98 | 185 | 11 | 42 | 130 | 19,000 |
| KMC-218 | CSP, QFN | 95 | 1.94 | 180 | 13 | 38 | 130 | 19,000 |




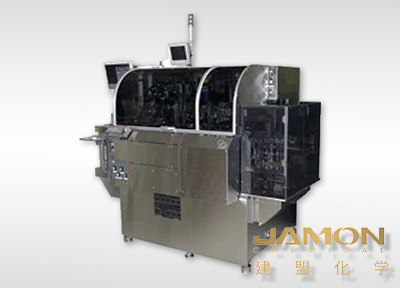

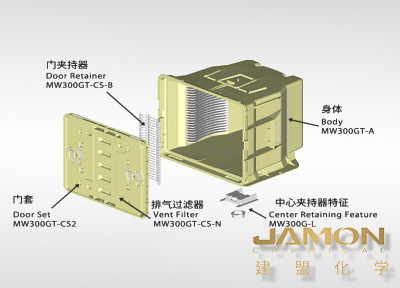




 扫描二维码 关注微信
扫描二维码 关注微信




